先端電子機器
デバイス研磨機 (ULTRA TEC)
デバイス研磨装置ASP-1

概要
パッケージデバイスの開封、裏面研磨、、ウェハーの部分研磨、プレディキャップまで行える、サンプル研磨装置。パッケージの材質はプラスティック、セラミック、タイプはCMP、QFP、BGA等、あらゆるタイプのパッケージに対応。
スタックチップパッケージ1stチップへの開封、ウェハーの部分研磨等、容易かつ、短時間で研磨。研磨方式は、加工時にほとんど発熱しないSAP方式を採用シリコン、パッケージを傷めません。
特徴
- すべてのチップサイズに対応します -パッケージ、ウェハーを問いません。
- 1台で開封、研磨までこなします。加工範囲、深さは高精度にコントロールできます。
- 各々の機能がわかりやすく使い易い。最高の加工結果が得られます。
- セットアップ、加工共に短時間。
- BGA、セラミックフリップチップ、パワーデバイス、MCM等のパッケージにも対応。パッケージでのチップの傾きにも加工中に対応できます。
- ベンチトップタイプの超小型。加工音も静かです。
- シリコン膜厚50ミクロン以下まで容易に研磨。
- ウェハーの部分研磨も可能。
サンプル研磨例

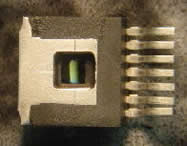

デバイスギャップ装置ASAP-DECAP

概要
デキャップ専用の研磨装置
メカニカル研磨により、パッケージ開封。パッケージ開封時、内部のチップやワイヤーを傷めずに開封できます。
特徴
- すべてのチップサイズに対応します。
- 加工範囲、深さは高精度にコントロールできます。
- 各々の機能がわかりやすく使い易い。最高の加工結果が得られます。
- セットアップ、加工共に短時間。
- BGA、セラミックフリップチップ、パワーデバイス、MCM等のパッケージにも対応。パッケージでのチップの傾きにも加工中に対応できます。
- ベンチトップタイプの超小型。加工音も静かです。
スタックチップ加工例
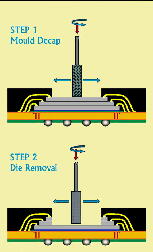
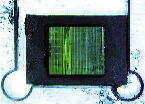
デキャップ加工例
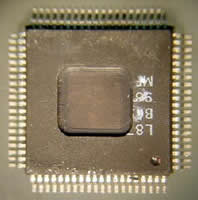
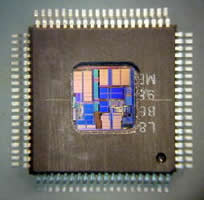
コーディング装置ARC-Lite

概要
パッケージ、ウェハーを室温状態でARコーティングできます。
作業時間1分以下、簡単にコーティング
特徴
- コーティング時間 45秒。
- フォトン検出感度30%アップ。
- 近赤外のコントラスト像60%アップ。
- ベンチトップ。
- すべてのパッケージタイプに対応。
- エミッションマイクロスコープ、レーザーFIB等の、裏面解析装置に最適。
ARコーティング例


平面研磨機MULTIPOL

概要
半導体チップ、パッケージの平面、断面研磨可能なシステムです。ウルトラオートコリメーターを用いることで、チップ両端の研磨誤差をサブミクロンでおこなえます。
特徴
- フラット研磨可能。
- ベンチトップ。
- ウルトラオートコリメーターによりサブミクロンの均一薄層加工。
- チップ、パッケージの平面、断面研磨可能。
- 多様なオプション。


