先端電子機器
薄膜およびMEMS用サンプルホルダー
薄膜およびMEMS用サンプルホルダー
シンプルな接触ステーションから革新的な「4 点曲げサンプルホルダー」まで、適切なサンプルホルダーを使用することで、薄膜や MEMS を確実かつ迅速に特性評価できます。
シンプルから革新へ
直径50µm未満の構造物との接触、薄膜における高電圧および/または温度依存性測定、あるいはKano/Muralt法を用いた逆e 31 ,f係数の決定など、薄膜およびMEMS用サンプルホルダーのポートフォリオはお客様のニーズに完璧に応えます。
ぜひご自身でご確認ください。
シンプルな連絡先
薄膜の特性評価のための当社の基本システムは、シンプルな接触ステーションです。
aixACCTが開発したプローブチップホルダーと併用するための、磁気ベースを備えたアクリル板で構成されています。
オプションで高解像度顕微鏡カメラもご用意しており、直径50µm未満の構造物への接触が可能です。
オプションのインターロックシステム付きカバーにより、高圧アンプの使用も可能です。最大サンプルサイズは8インチです。
特徴
- 使いやすい
- 最大8インチのサンプルサイズ
- RSモジュールを使用した4点測定用の最大4つのポジショナー
- オプションの高解像度顕微鏡カメラ
- インターロックシステムを備えた高電圧オプション
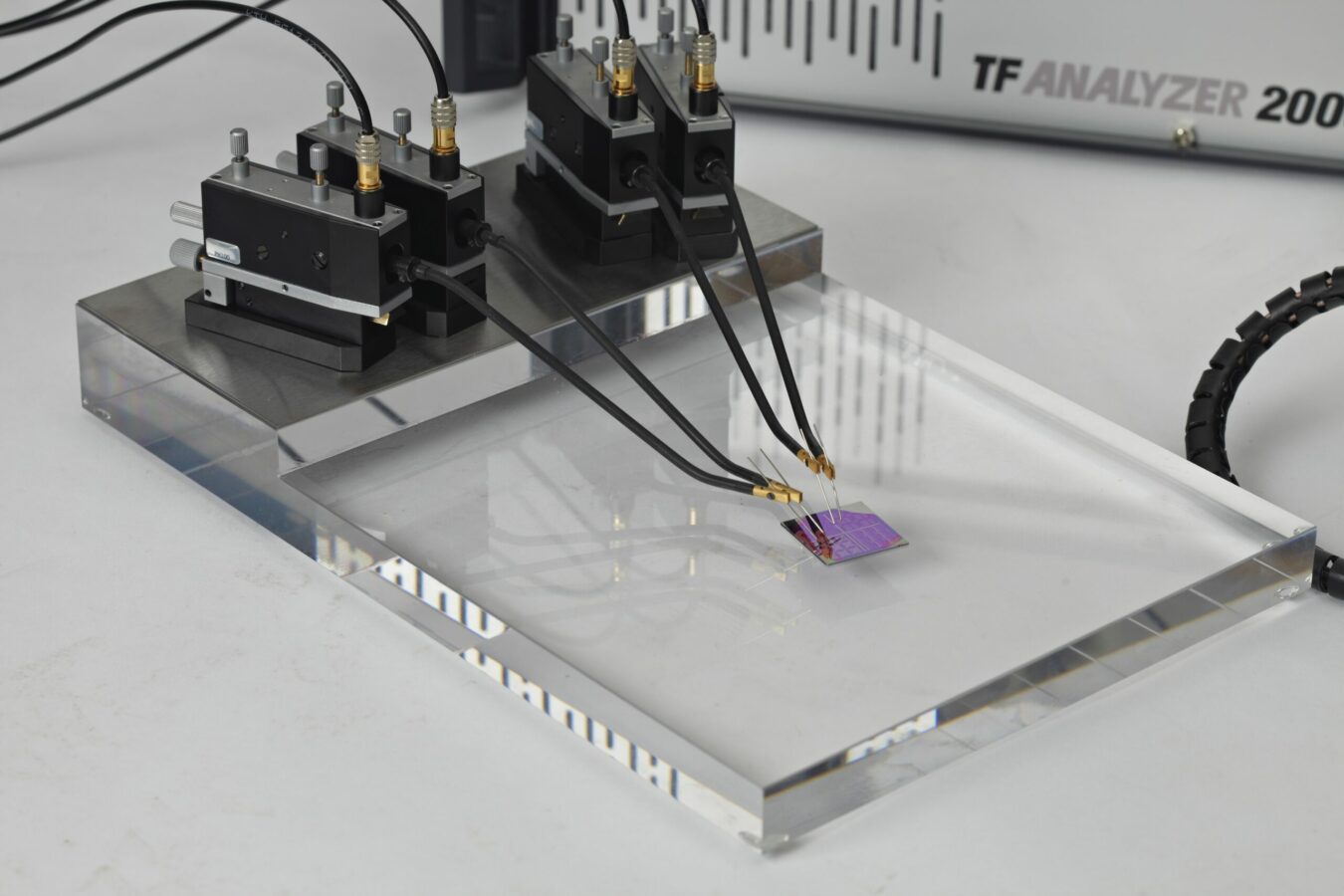

TFSHU
電気試験用の TFSHU サンプル ホルダーを使用すると、薄膜サンプルに対して高電圧や温度に依存する測定を実行できます。
アクチュエータやセンサー材料の開発には不可欠です。加熱ユニットはサンプルホルダーに一体化されているため、追加の温度チャンバーは不要です。
特徴
- MEMS部品を測定するにはサンプル表面を研磨する必要がある
- 切断サンプルの間接e 31係数を測定するための特殊アダプター
- インターロック保護回路
- 2つのポジショナーによるサンプルの接触
仕様
- 力発生用ピエゾアクチュエータを備えた4点曲げ試験片ホルダー最大250℃(サンプル上の温度測定)
- レーザーシステム用マウント0.1~10mm
- 簡単に接触する上部電極と下部電極最大25 x 25 mm²(1インチ x 1インチ)
- e 31測定とポーリングの自動切り替え最大400V
- 電気的および機械的疲労の測定
- 特殊なサンプル形状が必要
- 使いやすく正確なサンプル位置合わせを実現する特別な位置決めツール
| 温度 | 最大250℃(サンプル上の温度測定) |
| サンプルの厚さ | 0.1~10mm |
| サンプル直径 | 最大25 x 25 mm²(1インチ x 1インチ) |
| 張力 | 最大400V |
さらに、MEMS構造測定用レーザーは、位置決めシステムを追加することで強化できます。
改良されたカメラシステムと組み合わせることで、小型構造でも高精度な位置決めが可能になります。
オプションのサンプルホルダーを使用すれば、Kano/Muralt法を用いて逆e 31,f係数を求めることもできます。
オプションで温度範囲を最大500℃および/または-100℃まで拡張できます。これにより、強誘電体の高温材料を包括的に評価できます。



aix4PB
「4 点曲げサンプルホルダー」を使用すると、aixACCT Systems の革新的なパワーを体験できます。その設計により、薄膜内に均一で明確な機械的応力を生成できます。
これにより、定義された境界条件下での圧電係数e 31,f の正確な測定が保証されます。
サンプルを電気的に分極処理し、e 31,f係数を断続的に測定することも可能です。
これは、異なる分極処理条件がサンプルの性能に与える影響を調べる場合に便利です。
新しい統合アンプおよびスイッチングユニットにより、e 31,f係数の断続測定による疲労試験、DC電圧依存性の調査、さらにはh 31測定も実行できます。さらに、温度オプションにより、温度依存測定も可能です。
特徴
仕様
| 温度範囲 | 室温は最大200℃まで |
| 周波数範囲 | 10MHzから |
| 張力 | 最大400V(ポーリング用) |




